英特尔宣布已实现业界领先的半导体封装解决方案的大规模生产,其中包括英特尔突破性的3D封装技术Foveros。英特尔公司执行副总裁Keyvan Esfarjani表示:“先进封装技术让英特尔脱颖而出,帮助我们的客户在芯片产品的性能、尺寸,以及设计应用的灵活性方面获得竞争优势。”
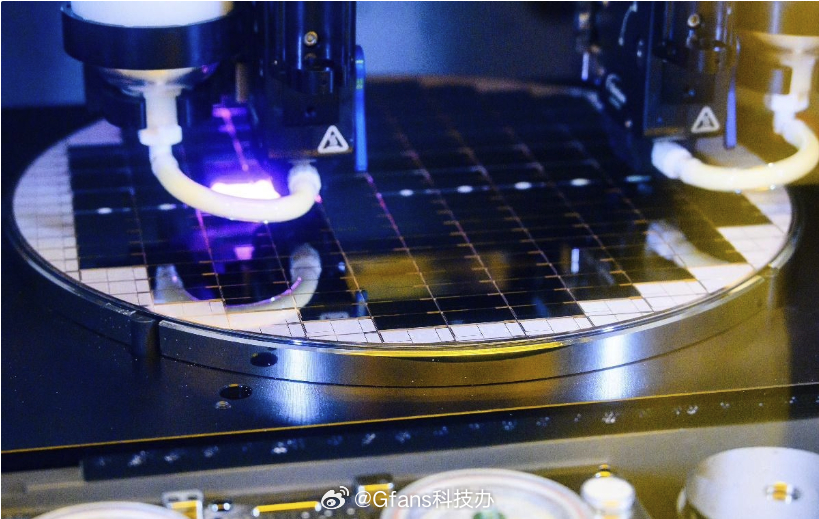
什么是Foveros,采用Forveros有什么好处
此次提到的英特尔Foveros技术是一种3D IC技术,也即一种3维集成电路。采用这种技术的芯片将和传统芯片在结构上有质的不同。
传统集成电路的制造方式是将晶圆经多次光掩模处理,将其光掩模上的电路克隆到每一层晶圆上。然后再进行刻蚀、掺杂等工序制成具有多层线路与器件的IC晶圆。最后将晶圆交给后段进行测试、切割、封装,以制成实体的集成电路成品。这导致了不同功能的芯片只能集成在基板,而不能融合成一颗芯片。
这样的设计虽然获得了巨大的成功,但是随着半导体产业的发展和AI大数据需求提升。传统设计在面对大数据和AI需求时,在数据搬运、处理和功耗控制方面并不友好。相关运算过程中大量数据搬运本身就会导致大量发热,同时基板的数据传输速度会限制芯片的处理能力。
而以Foveros为代表的先进封装则改变了芯片的通过基板连接方式。使用先进封装技术的芯片通过硅通孔、桥接器、硅中介层或导线层可以实现不同芯片之间完成更大规模串联,然后再封装成一颗芯片。这也就意味着存储芯片可以更快处理更多数据。
这种在一个芯片上集成多种不同材料、不同结构和不同功能元件的一体化技术也被称为异构/异质集成技术。